
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Sige in Chip Manufacturing: Professional News Report
Evolutionis Materiae Semiconductoris
In regno technologiae recentioris semiconductoris, improbus impetus ad miniaturizationem limites materiae silicon-basis traditae impulit. Obviis postulatis ad consummationem virtutis altae et infimae virtutis, Sige (Silicon Germanium) emersit ut composita electionis materia in semiconductore chip fabricandi ob singulares proprietates physicas et electricas. Hoc articulum in theprocessus epitaxyde Sige eiusque munere in incremento epitaxiali, applicationes Pii coactae et structurae Gate-All-Airand (GAA).
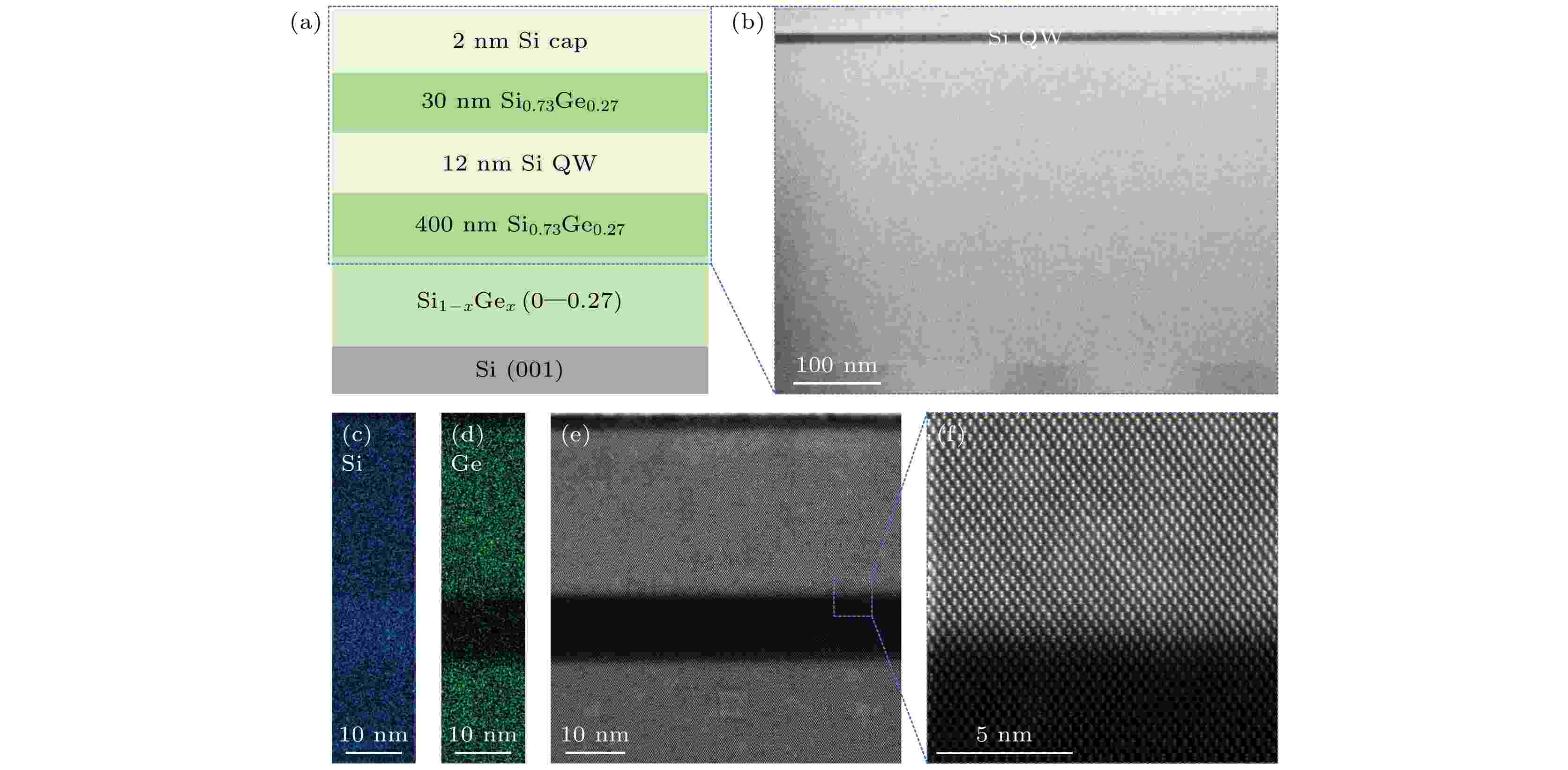
De significatione Sige Epitaxy
1.1 Introductio ad Epitaxy in Chip Vestibulum:
Epitaxia, saepe ut Epi abbreviata, ad incrementum unius-crystali in strato unius crystalli substratae cum eadem cancelli dispositione significat. Id accumsan velhomoepitaxial (ut Si / Si)vel heteroepitaxiales (ut Sige/Si vel SiC/Si). Varii methodi adhibentur pro incremento epitaxiali, inter Epitaxy (MBE), ultra-High Vacuum Vacuum Chemical Vapor Depositio (UHV/CVD), Epitaxia Atmosphaerica et Reducta Pressura (ATM & RP Epi). Hic articulus spectat in processibus epitaxiae siliconis (Si) et silicon-germanii (SiGe) late adhibitis in semiconductore integrali productionis cum materia silicone sicut materia subiecta.
1.2 Sige Epitaxy Commoda:
Proportio quamdam germanium in the incorporansprocessus epitaxySige unius cryptae format quae non solum latitudinem bandgap minuit, sed etiam frequentiam transistoris abscissorum auget (fT). Inde latius patet permagnum frequentiam machinarum pro wireless et opticis communicationibus socialibus. In processibus autem progredientibus CMOS ambitum integratis, cancellos mismatch (circiter 4%) inter Ge et Si cancellos accentus inducit, mobilitatem electronicorum vel foraminum augens et sic ad satietatem currentis et responsionis velocitatem machinae augens.
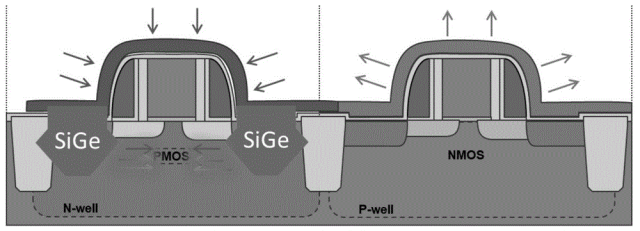
Processus Comprehensive Sige Epitaxy flow
2.1 Pre-curatio:
Silicon lagana praetractata sunt secundum eventus desideratos processus, imprimis ad remotionem oxydatis naturalis et immunditias in superficie lagana. Nam lagana gravis subiecta lagana graviter iactetur, pendet considerare an necessarium sit reducere auto-doping in subsequenti.incrementum epitaxy.
2.2 Augmentum gasorum et Conditiones:
Gases Pii: Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), et Trichlorosilane (TCS, SiHCl₃) sunt tres fontes gasi siliconis frequentissimi usi. SiH₄ ad low-temperantem plenam epitaxiam processuum aptus est, cum TCS, celeri incremento suo notus, late ad spissitudinem praeparationis adhibetur.Pii epitaxystratis.
Germanium gas: Germane (GeH₄) est prima origo ad germanium addendo, in conjunctione cum fontibus Pii ad mixturas Sige formandas.
Epitaxy selectiva: incrementum electionis selectivum fit componens rates relativumepitaxial depositioet in situ etching, usura chlorino-continens gasi DCS silicon. Selectivity ob adsorptionem atomorum Cl in superficie siliconis minorem esse quam in oxydis vel nitridibus, incremento epitaxiali faciliorem. SiH₄, cl atomis carens et cum energia activatione humilis, generaliter solum ad plenas epitaxy processuum humilis temperaturas applicatur. Alius fons siliconis communiter adhibitus, TCS, depressionem vaporis humilis habet et liquorem in cella temperatura habet, H₂ bullientem eum in cubiculum reactionem introducere postulans. Sed relative vilis est et saepe pro suo celeri incremento (usque ad 5 µm/min) usus est ad epitaxy siliconis crassiores stratis crescere, late in epitaxy lagani productio pii applicata.
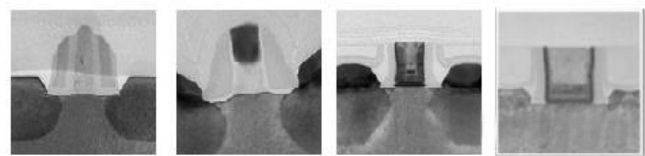
Silicon in Epitaxial Stratis
Perincrementum epitaxial, epitaxiale simplex Si cristallum in strato Sige dissoluto reponitur. Ob cancellos mismatch inter Si et Sige, Si singulae cryptae distrahentes accentus e strato Sige substratae subiectae sunt, signanter mobilitatem electronici in NMOS transistores augebant. Haec technologia non solum saturationem currentis (Idsat) auget sed etiam celeritas responsionis fabrica melioris. Cogitationes enim PMOS, stratae Sige epitaxially natae sunt in fonte et regiones exhaurire, postquam erigunt ad accentus compressivos in canalem inducere, mobilitatem foveam augere et satietatem augere.
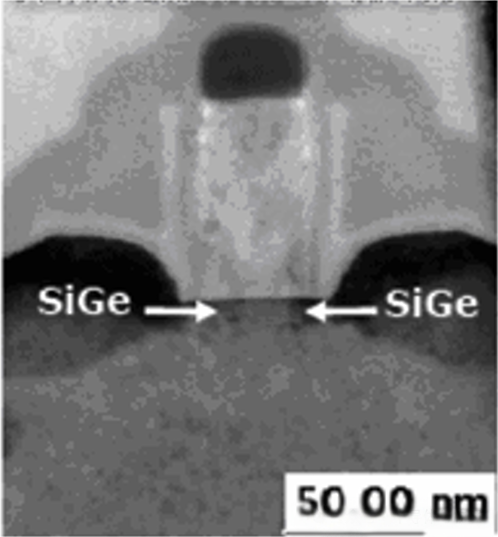
Sige in Stratum sacrificium in GAA Structures
In fabricandis transistoribus portae-All-Around (GAA) nanowire, strata Sige agunt stratis sacrificalibus. Summus selectivity anisotropicae etching technicae, sicut stratum quasi-atomicum etching (quasi-ALE), permittit ut strata accurata remotionis Sige formare structuras nanowire vel nanosheet.
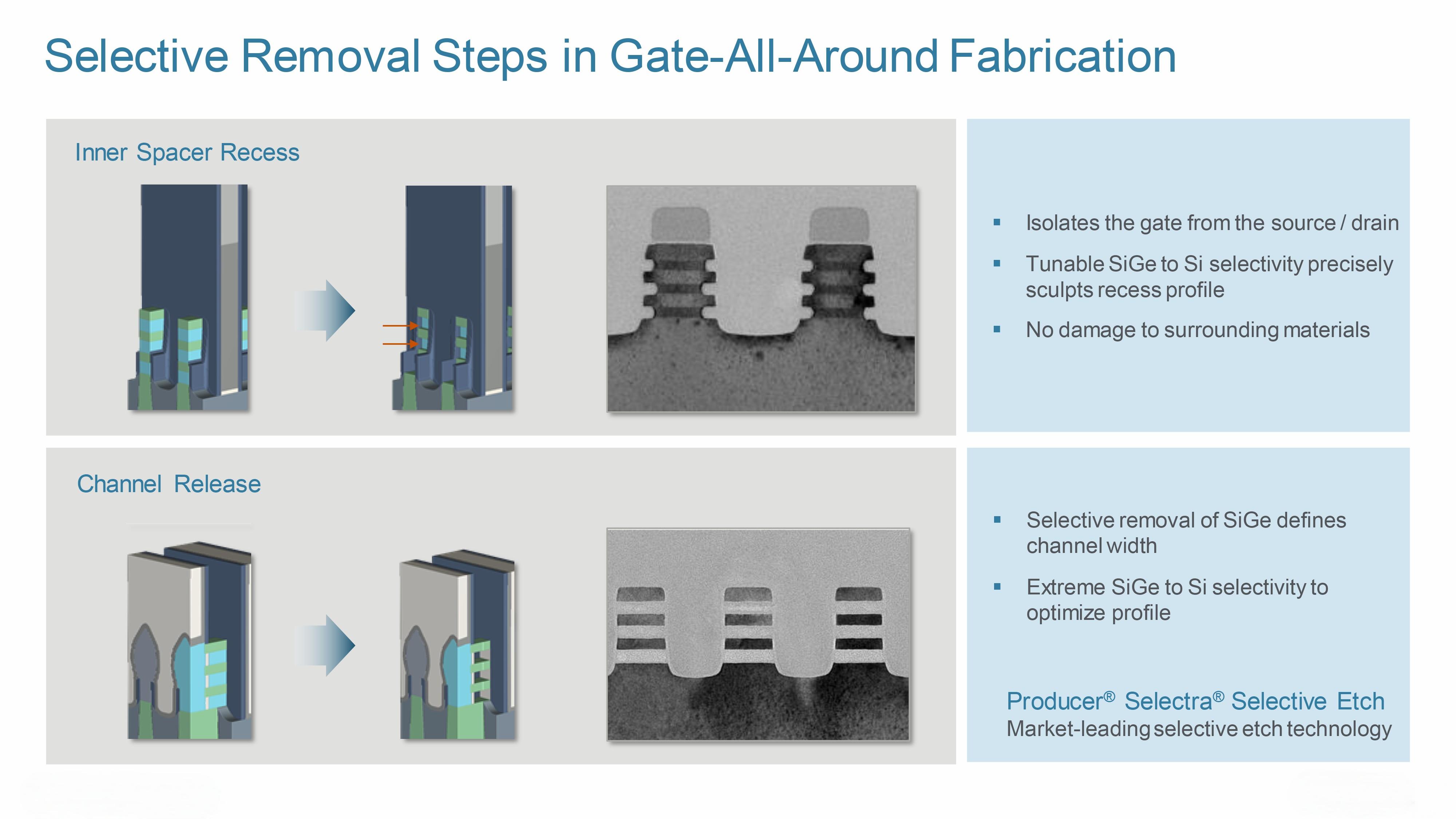
Nos ad Semicorex urna inSic / TaC graphite solutiones iactaretapplicata in Si epitaxial incrementum semiconductoris fabricationis, si quid habes inquisitionis vel egent adiectis rebus, quaeso ne dubita nobiscum attingere.
Contactus telephonicus: +86-13567891907
Email: sales@semicorex.com




