
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Chip Vestibulum tenuis processibus
What is the Basic Introduction to thin Film Processes?
Processus depositionis semiconductor tenuis cinematographicus essentiale elementum technologiarum microelectronicarum modernarum est. Complexum ambitus integratos construendo implicat ponendo unam vel plures bracteas materiae in semiconductore subiectae. Hae membranae tenues esse possunt metalla, insulatores, vel materias semiconductores, singulae partes varias in variis laminis spumam habent, ut conductio, insulatio, tutela. Quales hae membranae tenues directe impingunt ad effectum, fidem et sumptus chip. Ideo technologiae tenuis cinematographicae depositionis progressus ad semiconductoris industriam magni momenti est.

Quomodo tenues Processus Classifieds?
In statu, amet tenuis pellicula depositio instrumenti et technicae artis includitPhysica Depositio Vapor (PVD), Vapor Chemical Depositio (CVD), et Iacuit atomicus Depositio (ALD). Hae tres artes notabiliter differunt in principiis depositionis, materiae, applicatae stratis cinematographicis et processibus.
1. Vaporem Physicum Depositio (PVD)
Depositio Vaporis Physica (PVD) est processus mere physicus in quo materiae per evaporationem vel salientes vanescunt et tunc condensantur in substratum ad tenuem cinematographicam formam.
Vacuum evaporatio: Materiae calefactae sunt ad vaporizationem sub magnis conditionibus vacuo et in substratum depositum.
Putris: Gas iones generatae ex bombardarum missione gasi materiali oppugnationis in magna celeritate, atomis deiectis quae cinematographicam in substratis faciunt.
Ion Plating: Componit commoda vacui evaporationis et putris, ubi materia vaporizata partim ionizata est in spatio emolutionis et ad subiectam cinematographicam formam attrahitur.
Characteres: PVD involvunt solas mutationes physicas sine chemicis profectae.
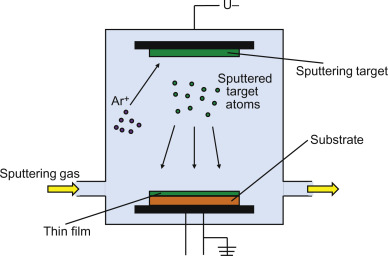
2. Vapor Chemicus Depositio (CVD)
Vapor chemicus Depositio (CVD) ars est quae reactiones chemicos gas-phasi implicat ut membranas solidas tenues in subiecto subiciat.
Conventional CVD: Idoneum ad deponendos varias membranas dielectric et semiconductores.
Plasma amplificatus CVD (PECVD): plasma utitur ad reactionem augendam activitatem, ad depositionis temperaturam aptam.
Summus densitas Plasma CVD (HDPCVD): Permittit simul depositionem et engraving, praestantem aspectum summo aspectu offerens capacitatem hiatus implendi.
Sub-atmosphaerica CVD (SACVD): praeclaras facultates foveas implens sub condiciones pressionis obtinet utendo radicales magni reactivos oxygenii ad altas temperaturas formatos.
Metal-organicum CVD (MOCVD): Apta materiarum semiconductorum sicut GaN.
Characteres: CVD involvunt gas-phase reactantes ut silane, phosphinum, boranum, ammoniacum, oxygenium, solidas membranas sicut nitrides, oxydi, oxynitrides, carbides, et polysilicon sub temperatura, alta pressura, vel plasma conditiones.
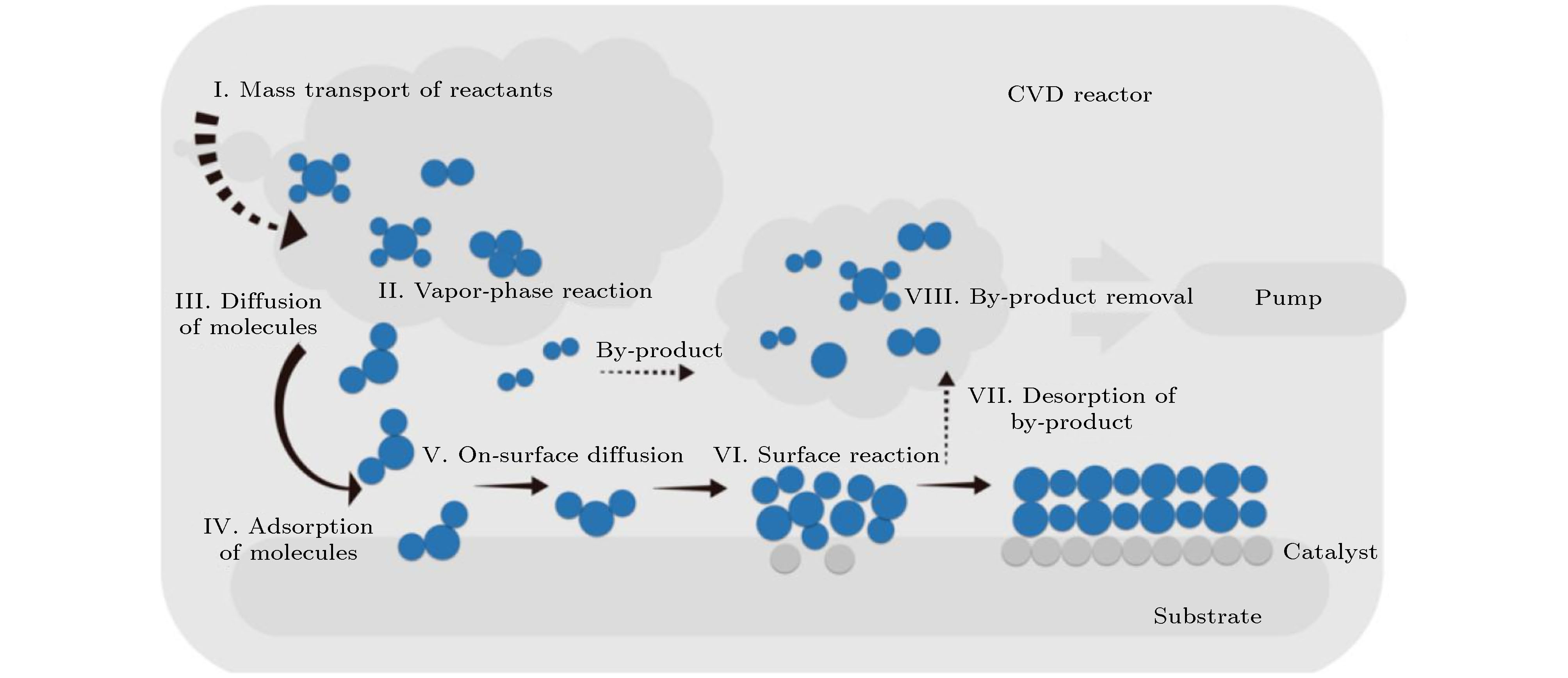
3. Stratum atomicum Depositio (ALD)
Depositio atomica Stratum (ALD) est ars specialissima CVD quae involvit alternas introductiones pulsantium duarum vel plurium reactantium, assequendum depositionem strati unius-atomi-amici accuratam.
Scelerisque ALD (TALD): energia scelerisque utitur ad adsorptionem praecursoris et subsequentem reactiones chemicae in subiecto.
Plasma-ALD (PEALD) usus plasma ad augendam reactionem activitatem, permittens celerius depositionis rates in inferioribus temperaturis.
Characteres: ALD offert subtilis pelliculae crassitudinem temperantiae, aequabilitatis et constantiae praestantem, eamque aptissima cinematographici incrementi in structurarum profundarum fossarum facit.
Quomodo variae tenues processus in Chips applicatae?
Lamina metalla: PVD principaliter ponitur ad deponendi ultra-puram metallicam et transitum metallicae pelliculae nitridae, sicut aluminium pads, larvis metalli duris, obice aeris, stratis aeris, et seminis aeris stratis.
Codex Al: pads vinculi pro PCBs.
Metalla dura larva: Vulgo Tin, in photolithographia adhibita.
Cu Obex Stratum: Saepe TaN, impedit Cu diffusio.
Cu Semen Layer: Purus Cu vel Cu mixtura, iacuit in semine postea electroplatandi usus.
Stratis dielectric: CVD maxime adhibetur ad varias insulandas materias deponendas ut nitrides, oxydi, oxynitrides, carbides, et polysilicon, quae varias partes ambitus segregant et impedimentum minuunt.
Gate Oxide Layer: Isolates porta et varius sapien.
Interlayer Dielectric: Isolates varias stratas metallicas.
Obex Stratis: PVD adhibetur ad diffusionem metallicam ne et machinas a contagione defendat.
Cu Obex Stratum: aeris diffusio praevenit, effectus machinam procurans.
Durum larvarum: PVD in photolithographia adhibetur ad structuras fabricas definiendas adiuvandas.
Metallum durum larva: Vulgo Tin, exemplaria definire solebant.
Self-Aligned Duplex Patterning (SADP): ALD utitur laminis ad exemplaria pulchriora, apta ad fabricandas structuras in FinFETs.
FinFET: Utitur ad margines nuclei formas duras stratas creare, multiplicationem spatialem attingens frequentiam.
High-K Porta Metallica (HKMG): ALD adhibetur ad altas dielectricas materias constantes et portas metallicas deponere, transistoris perficientur emendans, praesertim in 28nm et infra processibus.
Summus K Dielectric Layer: HfO2 electio frequentissima est, cum ALD praelatus modus parandi sit.
Porta metallica: Developed ob incompatibilitatem elementorum Hf cum portis polysilicon.
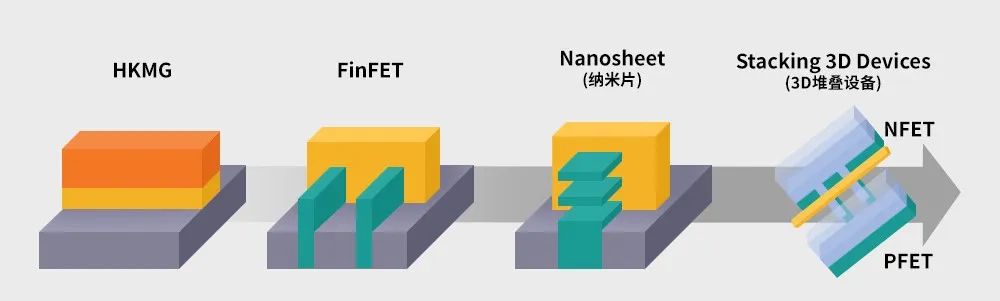
Alia medicamenta: ALD etiam late in aeris diffusione obice strata et aliae technologiae inter se connectunt.
Aeris Interconnect Diffusio Obex Stratum: Diffusio aeris impedit, perficiendi fabrica protegens.
Ex praefata praefatione notare possumus PVD, CVD, ALD singulares notas habere et commoda, in functionibus semiconductoribus substituendas partes ludentem. PVD principaliter ponitur pro depositione cinematographici cinematographici, CVD apta est variis depositionibus dielectric et semiconductoris cinematographici, dum ALD in processibus provectis cum superiori suo crassitudine imperium et gradum coverage facultates praestat. Continua progressio et humanitas harum technologiarum fundamentum solidum praebent ad profectum industriae semiconductoris.
Nos ad Semicorex urna inCVD SiC/TaC coating componentsadhibitis in fabricandis semiconductoribus, si quas inquisitiones habes vel singulas alias necessitates habes, quaeso ne nobiscum tactus dubitas.
Contactus telephonicus: +86-13567891907
Email: sales@semicorex.com




